
| EUV 투과막 제작
| 문서번호 | PLA03201702 | 작성일 | 2017. 09. 19. |
| 소속 | 나노종합기술원 | 담당자 | 이기성 |
| 연락처 | 042-366-1534 | 이메일 | comesee@nnfc.re.kr |
[ 공 정 규 격 서 ] |
|||
| 공정명 | EUV 투과막 제작 | 공정분류 | 공정 |
| 1. 공정 목적 및 용도 | |||
|
○ 공정 목적 극자외선 (13.5 nm)를 투과하는 멤브레인 구조의 제작을 위한 기본 공정 ○ 공정 용도 극자외선 노광기술(EUVL)은 현행의 ArF 노광기술에 비해 짧아진 파장을 사용하기 떄문에 해상력을 향상시킬 수 있지만, 최종 전사 패턴에 영향을 줄 수 있는 결함의 critical size가 수십 nm 단위로 작아질 것으로 예상됨. 따라서 EUVL 양산 적용을 앞둔 현 시점에서 노광공정 중 발생하는 결함을 효과적으로 제어하고 관리 이슈로 대두되고 있으며, 이를 해결하기 위해 EUV 마스크용 펠리클의 개발이 필요함. 본 공정은 수십 nm 두께의 EUV 펠리클 제작을 위한 용도로 사용됨. |
|||
| 2. 공정 구조 및 특성 | |||
○ 공정 구조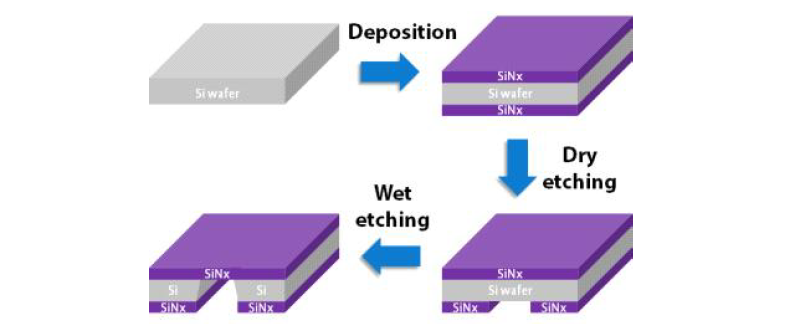 - Dry etching : RIE를 이용한 멤브레인 면적의 SiNx etching - Wet etching : KOH 용액에 의한 Si wet etching ○ 공정 특성 - SiNx Pellicle 규격 : < 110mm*144mm (멤브레인 윈도우 크기 기준) EUV transmittance : <80% (13.5nm 기준) |
|||
| 3. 공정순서 | |||
 |
|||
| 4. 공정 조건 | |||
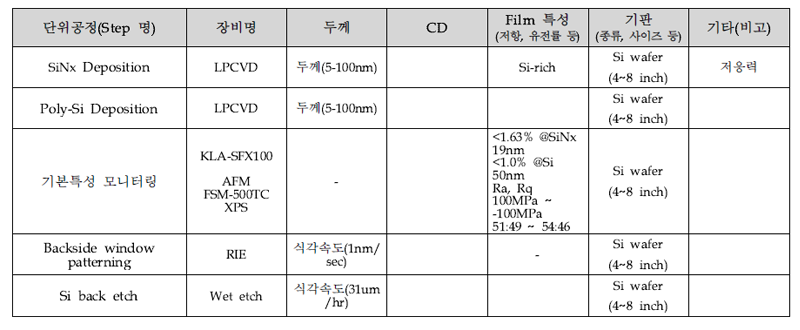 - 기계적, 열적 보강층을 포함한 복합구조체 박막 제작 플랫폼으로 활용 가능 |
|||

