
| 압저항형 압력센서 일관 표준공정 플랫폼
| 문서번호 | PLA06201710 | 작성일 | 2018. 03. 26. |
| 소속 | 나노융합기술원 | 담당자 | 최경근 |
| 연락처 | 054-279-0212 | 이메일 | choikk@postech.ac.kr |
[ 공 정 규 격 서 ] |
|||
| 공정명 | 압저항형 압력센서 일관 표준공정 플랫폼 | 공정분류 | 공정 |
| 1. 공정 목적 및 용도 | |||
|
○ 공정 목적 : MEMS 기반의 압저항형 (Piezo-resistive) 압력센서는 자동차, 의료, 가전, 산업, 항공 등 다양한 분야에서 공업계측, 자동제어, 자동차 엔진제어, 환경 제어 등 그 용도가 다양하고 가장 폭넓게 사용되는 센서중 하나임. 정전 용량형 압력센서에 비해 고압의 압력 범위에서 적용이 가능하고 특히 SiC 기반 핵심센서 개발로 새로운 센서 시장 진출 및 솔루션 부가가치 창출이 기대됨. ○ 공정 용도 : 압저항형 압력센서는 외부 인가 압력인 기계적 신호를 감지 멤브레인 위에 Wheatstone Bridge 형태의 전극이 전기 신호로 전환하며, 이때 센서의 감도(S)는 아래와 같다.  |
|||
| 2. 공정 구조 및 특성 | |||
|
○ 공정 구조(사진 및 모식도/구조도 등) : 극한 환경에 압력센서를 적용하기 위해서는 안정한 압저항 박막 전극이 필요 ○ 압저항형 압력센서 제작을 위한 작업도 (Run Sheet) 및 일관 공정 순서도 : 기판 절연→ 압저항 전극 형성 공정 → 보호막 증착 공정→ 배선 형성 공정→ Backside 식각 (멤브레인 형성) 1) 절연막 및 보호막 증착 공정 : Low Stress 박막 2) 압저항 전극 : Low TCR 박막 (Ni-Cr, poly Si, SiC 박막 등) 3) 배선 공정 : 오믹 콘택, 고온 안정성 박막 4) Si, SiC 식각 공정개발 : Deep Etch 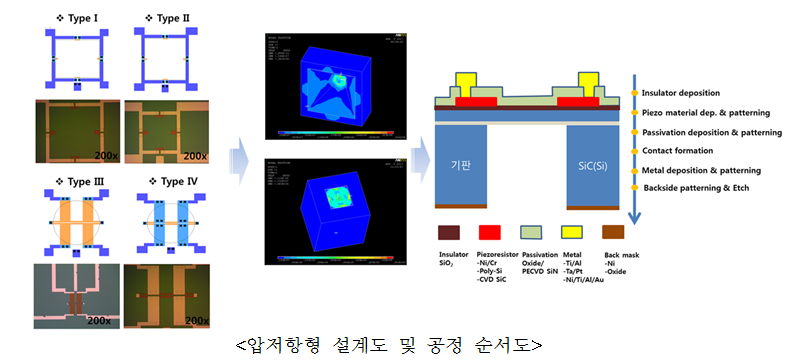 ○ 공정 특성 : 단위공정과 모듈공정 확립으로 압저항형 압력센서 일관 (full) 공정으로 센서 동작 및 설계 검증 - Si, SiC 기반 Deep Etch 특성 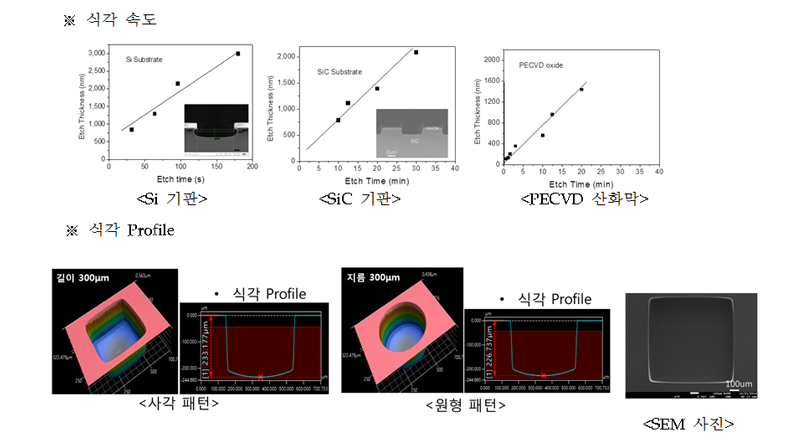 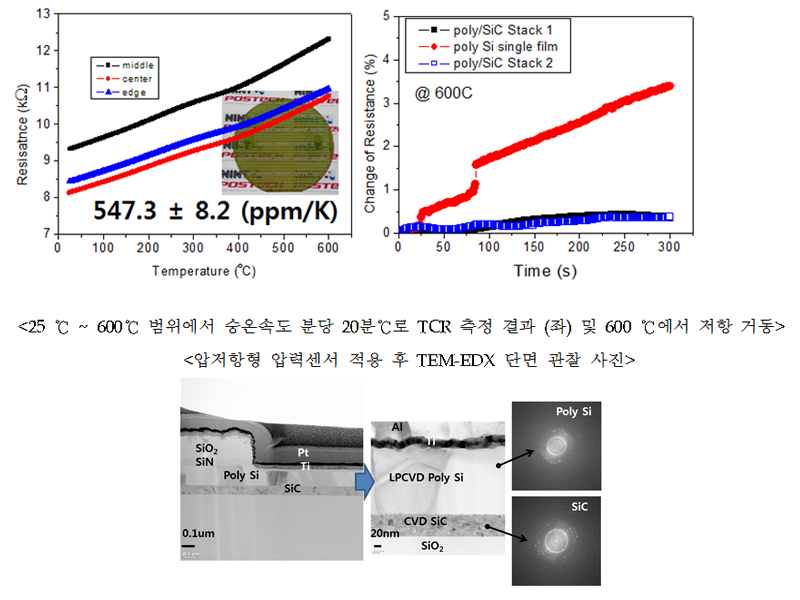 ※ 센서 특성 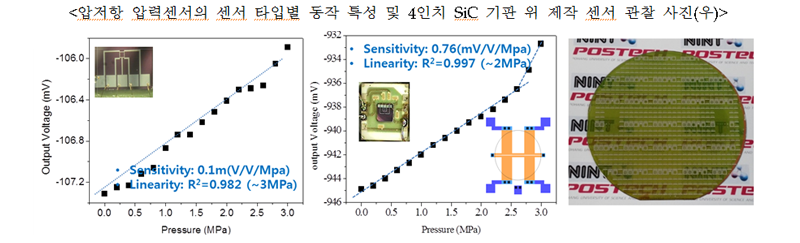 |
|||
| 3. 공정순서 | |||
 |
|||
| 4. 공정 조건 | |||
 |
|||

