
| Chip to Wafer Bonding용 Solder Ball Contact 제작 표준 공정
| 문서번호 | PLA03202002 | 작성일 | 2020. 05. 29. |
| 소속 | 나노융합기술원 | 담당자 | 김인철 |
| 연락처 | 010-7518-6637 | 이메일 | ickim@postech.ac.kr |
[ 공 정 규 격 서 ] |
|||
| 공정명 | Chip to Wafer Bonding용 Solder Ball Contact 제작 표준 공정 | 공정분류 | 소자/센서 |
| 1. 공정 목적 및 용도 | |||
|
○ 공정 목적 다이 상태의 칩을 다이싱 되지 않은 웨이퍼 상에 부착하여 신호를 연결할 경우 사용. 다이 신호 연결 패드와 웨이퍼 상 연결 패드가 서로 마주본 상태에서 그 사이를 Solder ball을 이용하여 연결하는 공정 ○ 공정 용도 TSV를 이용한 신호선의 후면 연결이나, 플립칩 상태 신호선의 전면 연결을 위한 용도로 통상적인 와이어 본딩 연결 시 에폭시 몰딩에 의한 와이어 손상이 염려될 때 사용 가능. 보통 멤스 센서들은 컨택 패드 사이즈는 커서 여유가 있으나 와이어 본딩을 하기에는 와이어 자체 손상이 예상되는 경우에, 이러한 솔더 볼 연결이 효과적임 |
|||
| 2. 공정 구조 및 특성 | |||
|
○ 공정 구조 그림 1-3 처럼 상부의 센서 칩들은 적절한 패드 제작 공정 다이싱 되고, 하부의 웨이퍼는 적절한 패드 제작 공정 후에 센서의 하부에 위치하게 되고, 이후 두 패드 사이를 간단한 Solder Ball을 이용, 연결함. 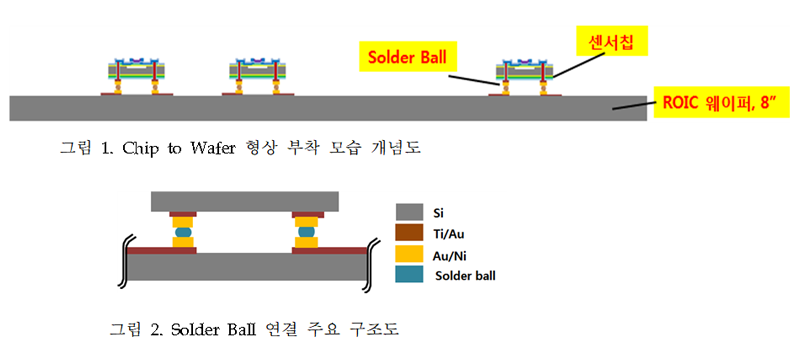 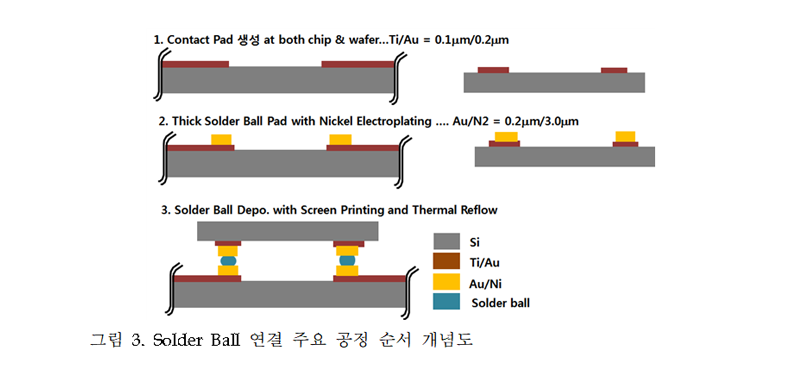 ○ 공정 특성 Contact Pad 생성 주기 ~O(500μm) Contact Pad 면적 200μm*200μm Solder Ball 직경 > 150μm |
|||
| 3. 공정순서 | |||
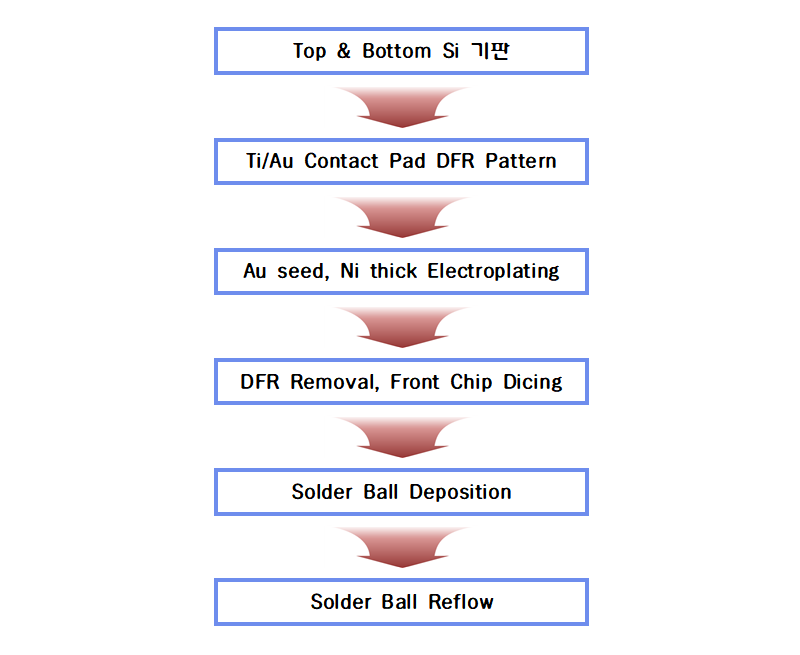 |
|||
| 4. 공정 조건 | |||
○ 공정 조건 ○ 공정 결과물 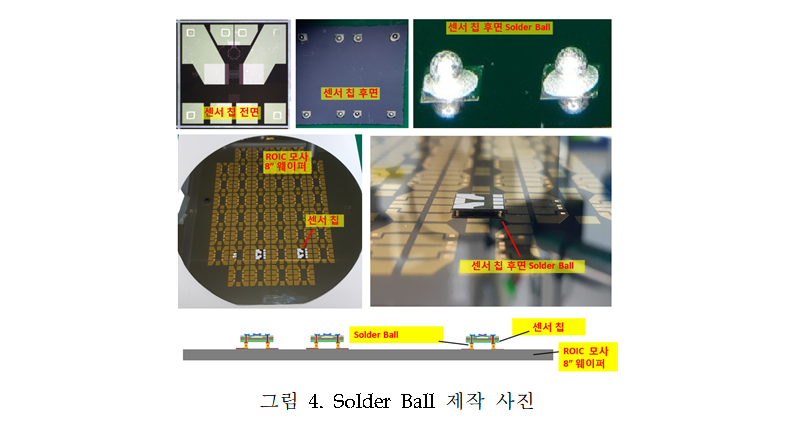 |
|||