
| 센서-구동회로 상하배선 TSV 연결기술 공정플랫폼
| 문서번호 | PLA04201704 | 작성일 | 2017. 09. 01. |
| 소속 | 나노융합기술원 | 담당자 | 김인철 |
| 연락처 | 054-279-0214 | 이메일 | ickim@postech.ac.kr |
[ 공 정 규 격 서 ] |
|||
| 공정명 | 센서-구동회로 상하배선 TSV 연결기술 공정플랫폼 | 공정분류 | 공정 |
| 1. 공정 목적 및 용도 | |||
|
○ 공정 목적 : 실리콘 센서와 구동회로(PCB 혹은 ROIC) 간 상하 배선 연결을 위하여 센서칩 중간에 배선 연결용 구멍(Through Hole Via, TSV, 이하 티에스브이라 칭함)을 생성 하는 공정. 이를 통하여 센서칩 전면의 센서부가 티에스브이를 통하여 센서 칩 후면에 위치한 구동용 회로(PCB 혹은 ROIC)와 상하로 연결이 되도록 함. 이러한 티에스브이 연결방식은 와이어 본딩(Wire Bonding) 연결 방식 대비 센서 표면 돌출부 제거 가능, 구동 회로 칩 크기 축소 등이 가능함 ○ 공정 용도 : 센서 구동용 구동회로 칩 크기를 최소로 하여야 하는 센서 제작센서 표면에 접촉하는 유동 왜곡 방지가 필요한 유동 특성 정밀 측정용 박막식 유량계,압력계, 온도계 센서 제작 등 |
|||
| 2. 공정 구조 및 특성 | |||
|
○ 공정 구조 그림 1처럼 상부의 실리콘 센서칩과 하부의 구동 회로가 센서칩의 상하를 관통하는 티에스브이에 의해 연결됨. 이때 티에스브이와 구동회로간의 연결은 그림 2처럼 별도의 솔더볼(Solder Ball)이나 범프(Bump) 등을 통하여 연결 가능함. 솔더볼이나 마이크로 범프 연결 공정은 추후 개발 예정이며, 여기서는 주로 티에스브이 제작 공정에 대해서만 기술함 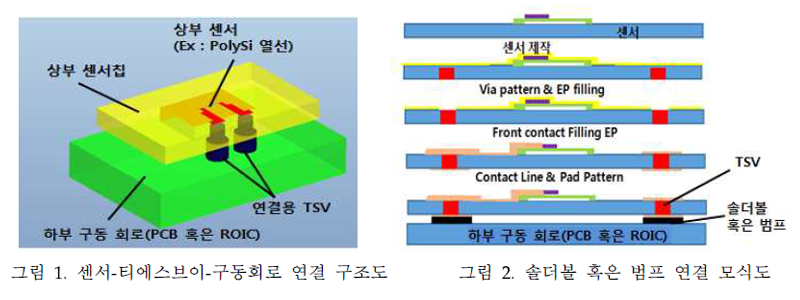 그림 3에는 티에스브이 제작을 위한 표준 공정 모식도를 나타내었는데, 공정 순서는 다음과 같음 - 센서칩용 기판에 대해서 먼저 비아 홀(Via Hole)을 가공하고, 이후 홀 내부를 절연함 - 이후 전면 도금용 전면 시드 레이어(Seed layer)를 코팅하고, 이후 비아를 채움 - 이후 구동 회로 연결을 위한 후면 단자를 생성함 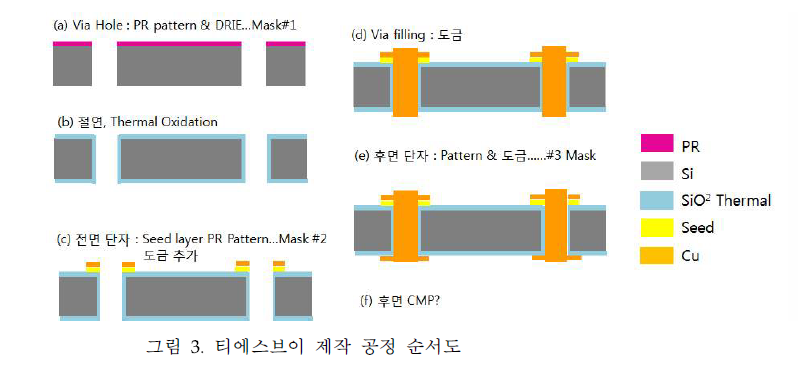 ○ 공정 특성 - 제작 가능 wafer : 6“, DSP --> (향후 8” 확대 예정) - 티에스브이 소재 : Cu - 티에스브이 제작 가능 형상 : 직경 D < 50μm, Wafer 두께 t > 500μm - 티에스브이 연결 저항 : 저항 100 mΩ 이하 (두께 150μm, 직경 100μm 사용 시) |
|||
| 3. 공정순서 | |||
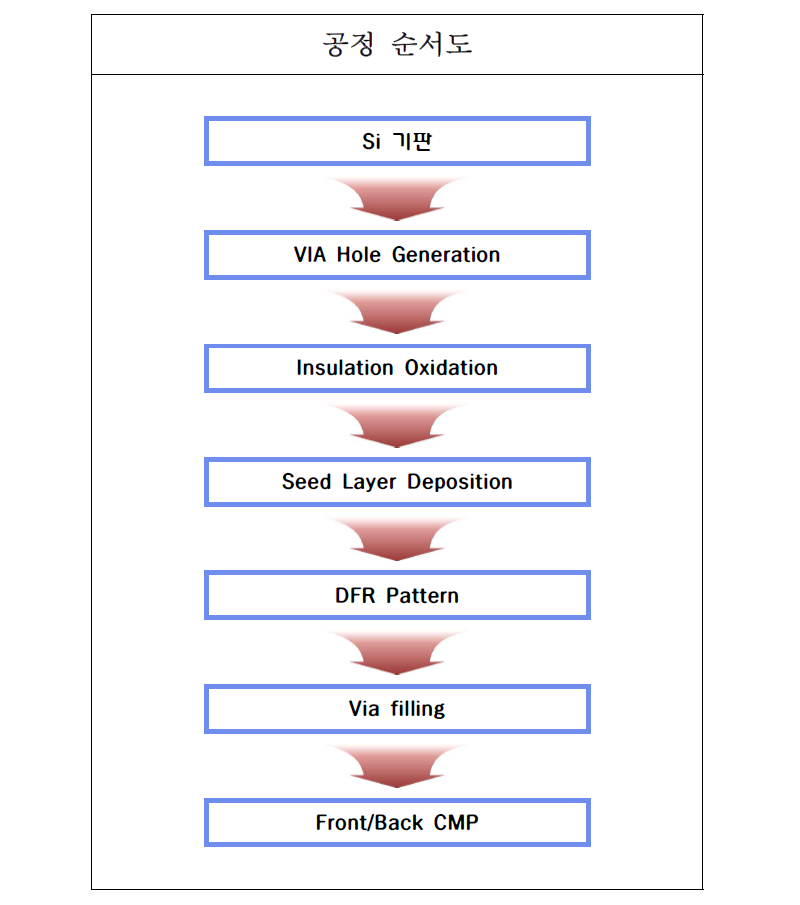 |
|||
| 4. 공정 조건 | |||
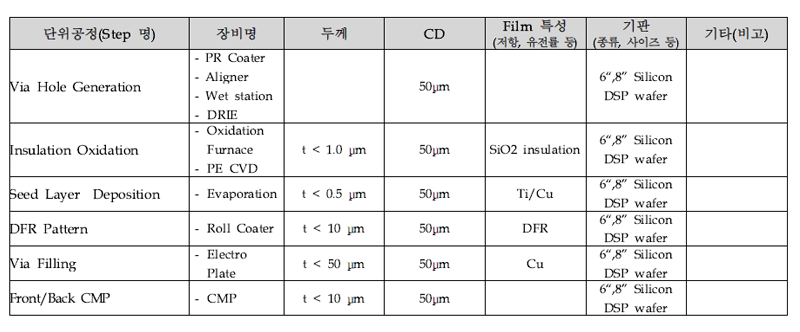 기타 - 상기 티에스브이 공정 적용을 위해서는 사전에 제작된 센서 칩 공정과의 호환 여부를 검토하여야 함. |
|||