
| 선택적 에피 성장된 저온 In-situ doped SiGe의 초저저항 S/D 컨택 형성 공정도
| 문서번호 | SA2019002 | 작성일 | 2019. 11. 26. |
| 소속 | 고려대학교 | 담당자 | 유현용 |
| 연락처 | 010-8589-8968 | 이메일 | yuhykr@korea.ac.kr |
[ 공 정 규 격 서 ] |
|||
| 공정명 | 선택적 에피 성장된 저온 In-situ doped SiGe의 초저저항 S/D 컨택 형성 공정도 | 공정분류 | 모듈공정 |
| 1. 공정 목적 및 용도 | |||
|
○ 공정 목적 미래 소자 집적화 기술로 각광받고 있는 3차원 적층 소자 구조 (M3D)에서 하부층 소자의 열화 현상을 방지하기 위해 550℃ 이하 저온에서 대면적 patterned Si 위 선택적 에피 성장(SEG)된 in-situ doped SiGe층은 현저히 높은 컨택 저항을 가지므로 소자의 전기적 특성 저하에 영향이 큼. 따라서 SiGe층의 높은 컨택 저항을 해결하기 위해 저온 Ni germano-silicide (NiSiGe) 컨택 형성 기술을 확보하고자 함. ○ 공정 용도 550℃ 이하 저온에서 대면적 patterned Si위 선택적 에피 성장된 in-situ doped SiGe 층에 저온 Ni germano-silicide 컨택 형성 기술을 도입하여 저온 공정으로 하부 소자의 열화 현상을 방지하며 5 x 10-8 Ω·cm2 이하의 초저저항 컨택을 형성한 고성능의 소자를 제작하기 위함. |
|||
| 2. 공정 구조 및 특성 | |||
○ 공정 구조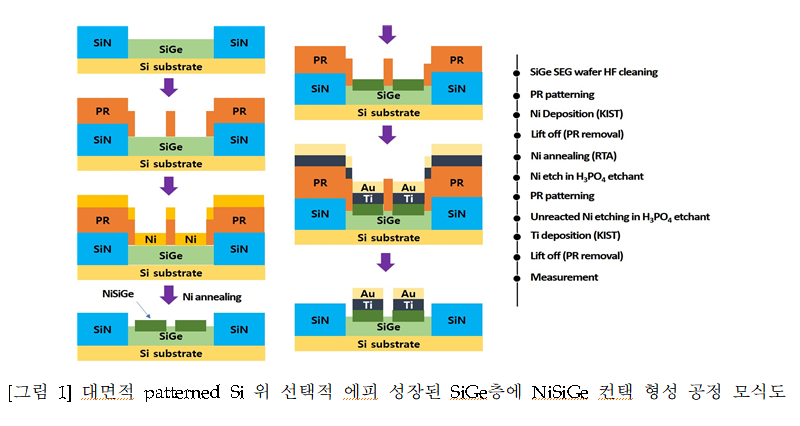 ○ 공정 특성 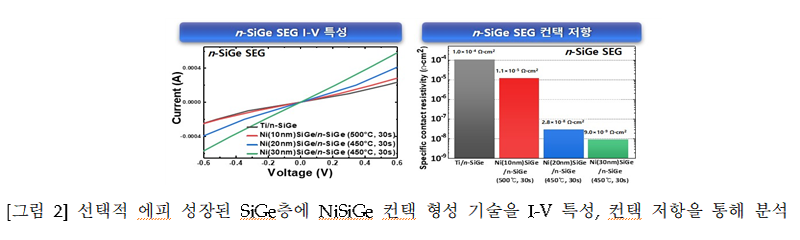 선택적 에피 성장된 SiGe층에 Ni germano-silicide (NiSiGe) 컨택 형성 공정 평가 - 분석 장비 : Keithley 4200 (4-point measurement) - 최저 컨택 저항 : 9 x 10-9 Ω·cm2 (과제 목표 5 x 10-8 Ω·cm2 이하 달성) - Ni 두께 : 30 nm - 공정 어닐링 온도 : 450 ℃ (과제 목표 550 ℃ 이하 달성) - 공정 어닐링 시간 : 45 초 |
|||
| 3. 공정순서 | |||
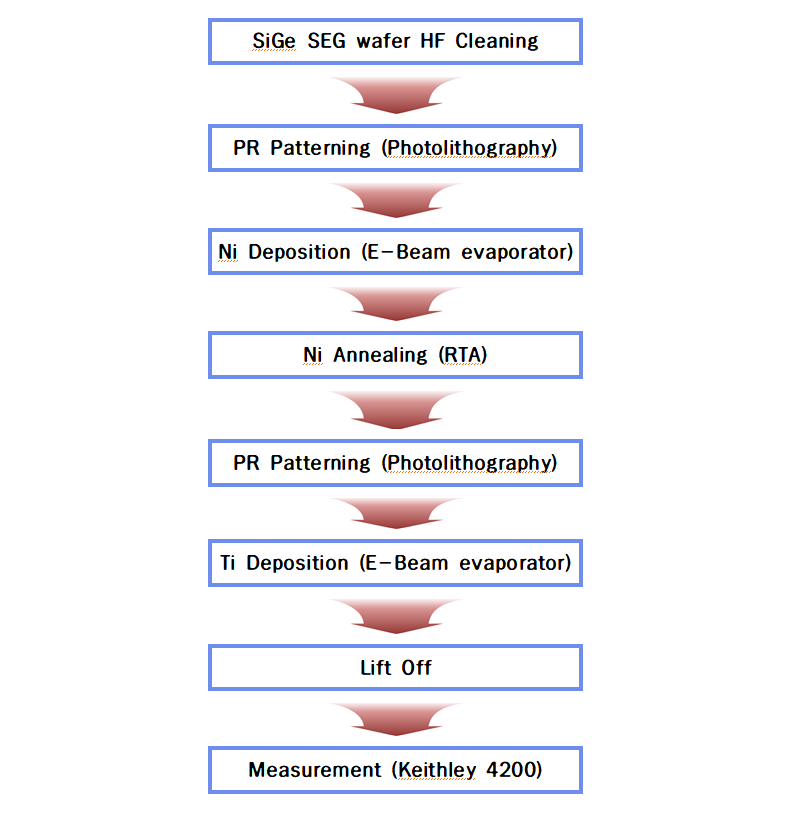 |
|||
| 4. 공정 조건 | |||
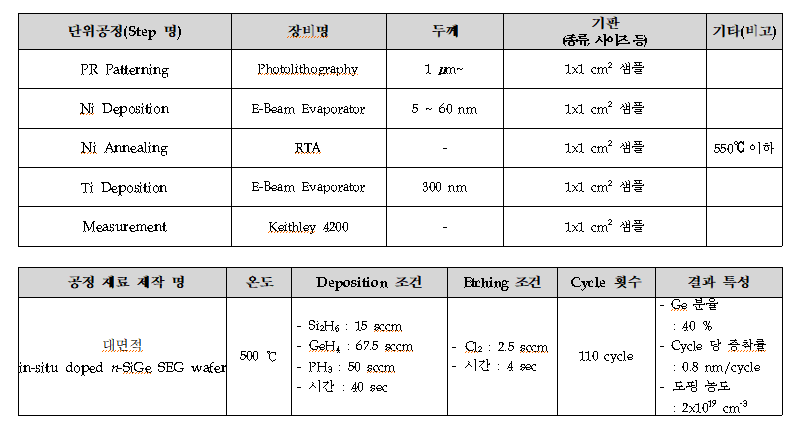 |
|||